01
PCB表面處理流程有哪些?
銅表面 PCB 沒有阻焊層覆蓋的部分,如焊盤、金手指、機械孔等。如果沒有保護層,銅表面容易被氧化,影響PCB可焊區域裸銅與元件的焊接。
如下圖所示, 表面 處理位於PCB的最外層,位於銅層之上,起到銅表面的「塗層」的作用。
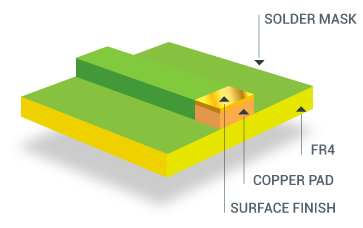
表面處理的主要作用是保護裸露的銅表面不會產生氧化電路,從而在焊接時為焊接提供可焊的表面。
02
PCB表面處理工藝的分類
PCB表面處理流程分為以下幾類:
熱風整平焊料 (HASL)
浸錫(ImSn)
化學鎳金(浸金)(ENIG)
有機可焊性防腐劑(OSP)
化學銀(ImAg)
化學鍍鎳、化學鍍鈀、沉金(ENEPIG)
電解鎳/金
熱風整平焊料 (HASL)
熱風整平焊錫(HASL),俗稱噴錫,是一種最常用且相對便宜的表面處理工藝。它分為 無鉛 噴錫和有鉛噴錫。
PCB的保存期限可達12個月,製程溫度為250℃,表面處理厚度範圍為1-40um。
噴錫製程包括將電路板浸入熔融的 焊接 (錫/鉛)覆蓋PCB上裸露的銅表面。當PCB離開熔化的焊料時,高壓熱風用風刀吹過PCB表面,使焊料平整沉積,並去除多餘的焊料。
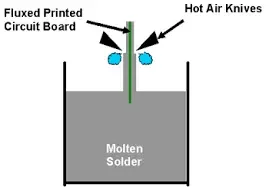
噴錫製程需要掌握好焊接溫度、刮刀溫度、刮刀壓力、浸焊時間、抬焊速度等。確保PCB完全浸入熔化的焊料中,風刀可以在焊料凝固前吹起。風刀的壓力可以最大程度地減少PCB上的彎月面。 銅表面 並防止焊錫橋接。
熱風整平焊料 (HASL)
優點:
保質期長
良好的焊接性
耐腐蝕、抗氧化
可以進行目視檢查
缺點:
表面不平整
不適用於間距較小的設備
易於生產錫珠
高溫變形
不適合通孔電鍍
浸錫(ImSn)
沉錫(ImSn)是透過化學置換反應沉積的金屬鍍層,直接塗在電路板的基底金屬(即銅)上,可以滿足小間距元件對PCB表面平整度的要求。

錫沉積可在3-6個月的保質期內保護底層銅免受氧化。由於所有焊料都以錫為基礎,錫沉積層可與任何類型的焊料相符。在錫浸液中添加有機添加劑後,錫層結構變得顆粒狀,克服了錫須和錫遷移帶來的問題,同時也具有 良好的熱性能 穩定性和可焊性。
沉錫製程溫度50℃,表面處理厚度0.8-1.2um,特別適合通訊背板等需要壓接連接的PCB。
浸錫(ImSn)
優點:
適合小間距/BGA
良好的表面光滑度
符合 RoHS
良好的焊接性
穩定性好
缺點:
容易被污染
錫須可能造成短路
電氣測試需要軟探針
不適用於接觸開關
對阻焊層有腐蝕作用
化學鎳金(浸金)(ENIG)
化學鎳浸金(ENIG)可以滿足小間距元件(BGA和μBGA)對PCB表面平整度和無鉛加工的要求。
沉金(ENIG)由兩層金屬鍍層組成,鎳透過化學過程沉積在銅表面,然後透過置換反應覆蓋金原子。鎳的厚度為3-6微米,金的厚度為0.05-0.1微米。鎳作為銅的屏障,是元件實際焊接的表面。金的作用是防止鎳在儲存過程中氧化,保存期限約一年,可確保 優異的表面平整度.
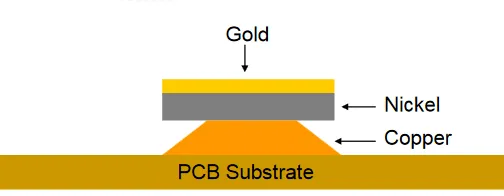
沉金製程廣泛應用於高密度板、傳統硬板、軟板,可靠性高,支援鋁線鍵合,廣泛應用於消費性電子、通訊/運算、航空航太、醫療保健等產業。
化學鎳金(ENIG)
優點:
保質期長
高密度板(μBGA)
鋁線鍵合
表面平整度高
適用於電鍍孔
缺點:
昂貴的價格
射頻訊號衰減
無法返工
黑墊/黑鎳
加工過程複雜
有機可焊性防腐劑(OSP)
有機可焊性保護劑 (OSP) 是一種非常薄的材料保護層,塗在暴露的銅上,以保護銅表面免受氧化。
有機膜具有抗氧化、抗熱震、抗潮濕等特性,在正常條件下可保護銅表面免於氧化或硫化。在高溫焊接後,有機膜很容易被助焊劑去除,使裸露的清潔銅表面立即與熔化的金屬結合。 焊接,在很短的時間內形成牢固的焊點。
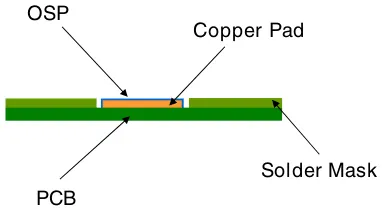
OSP是一種水性有機化合物,可以選擇性地與銅結合,在焊接前保護銅表面。與其他無鉛表面處理製程相比,它非常環保,因為其他表面處理製程可能具有毒性或更高的能耗。
有機可焊性防腐劑(OSP)
優點:
簡單又便宜
無鉛環保
光滑的表面
引線接合
缺點:
不適合 PTH
保質期短
不便於目視和電氣檢查
ICT 夾具可能會損壞 PCB
化學銀(ImAg)
浸銀(ImAg)是將PCB板浸入銀離子槽中,透過置換反應,在銅上直接鍍上一層純銀的製程。銀具有穩定的化學性質。經過浸銀技術處理的PCB板即使暴露在高溫、潮濕、污染的環境中,即使表面失去光澤,也能保持良好的電氣性能和可焊性。
有時,為了防止銀與環境中的硫化物反應,銀沉積會與OSP塗層結合使用。在大多數應用中,銀可以替代金。如果您不想在PCB中引入磁性材料(鎳),則可以選擇使用銀沉積。
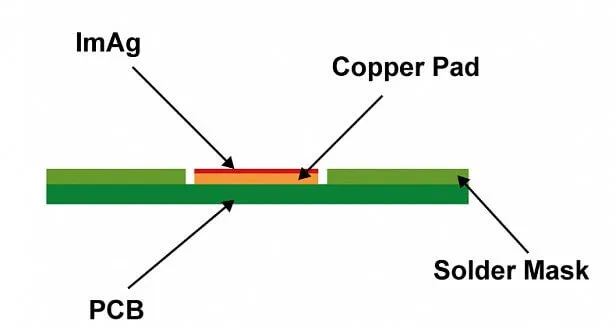
銀沉積表面厚度為0.12-0.40μm,保存期限為6至12個月。銀沉積製程對加工過程中表面的清潔度較為敏感,需要確保整個生產過程不會造成銀沉積表面的污染。銀沉積製程適用於PCB、薄膜開關、鋁線鍵結等需要EMI屏蔽的應用。
沉沒的銀子(ImAg)
優點:
表面平整度好
高焊接性
穩定性好
屏蔽性能好
適用於鋁線鍵合
缺點:
對污染物敏感
易於發生電遷移
銀色金屬晶須
拆包後組裝時間短
電氣測試困難
化學鍍鎳、化學鍍鈀、沉金(ENEPIG)
與ENIG相比,ENEPIG在鎳和金之間增加了一層鈀,進一步保護鎳層免受腐蝕,並防止ENIG表面處理過程中可能出現的黑焊盤,從而在表面平整度方面具有優勢。鎳的沉積厚度約3-6μm,鈀的厚度約為0.1-0.5μm,金的厚度為0.02-0.1μm。雖然ENEPIG的厚度 金層 比ENIG更薄,價格更貴。
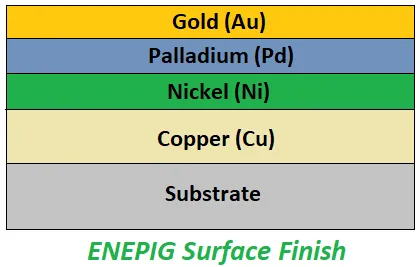
銅鎳鈀金的層狀結構可直接與電鍍層進行引線鍵結。最後一層金非常薄且柔軟,過度的機械損傷或較深的刮痕可能會暴露鈀層。
化學鍍鎳、化學鍍鈀、沉金(ENEPIG)
優點:
極為平坦的表面
引線接合
可多次回流焊接
焊點可靠度高
保質期長
缺點:
昂貴的價格
金線鍵合不如軟金鍵合可靠
易於生產錫珠
複雜的過程
加工過程難以控制
電解鎳/金
電鍍鎳金分為「硬金」和「軟金」。
硬金純度較低(99.6%),常用於金手指 (PCB邊緣連接器)、PCB觸點或其他易磨損區域。鍍金厚度可依需求調整。
軟金純度較高(99.9%),常用於引線鍵結。
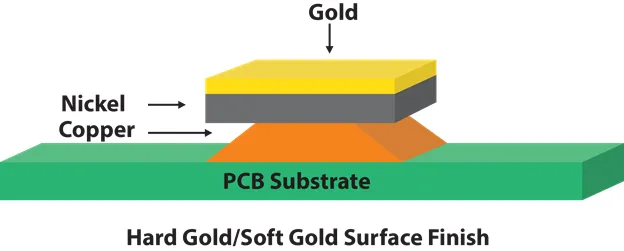
硬質電解質金
硬金是一種含有鈷、鎳或鐵絡合物的金合金。低應力鎳層位於鍍金層和銅層之間。硬金適用於頻繁使用且易磨損的元件,例如載板、金手指和按鍵。
硬金表面處理的厚度可能因應用而異。 IPC 建議最大可焊厚度為 17.8 μ 英寸;IPC25 和 100 類應用建議最大可焊厚度為金 1 μ 英寸,鎳 2 μ 英寸;IPC50 應用建議最大可焊厚度為金 100 μ 英寸,鎳 3 μ 英寸。
軟電解金
主要用於需要引線鍵合和高可焊性的PCB,軟金焊點比硬金更安全。
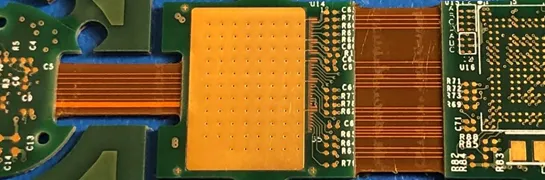
軟電解金表面處理
電解鎳/金
優點:
保質期長
焊點可靠度高
耐用的表面
缺點:
非常貴
金手指需要在電路板上額外佈線
硬金可焊性差
03
PCB表面處理工藝該如何選擇?
PCB的表面處理製程將直接影響產量, 返工數量、現場故障率、測試能力、報廢率等。為了最終產品的品質和性能,需要選擇符合設計要求的表面處理流程。在工程上,可以從以下角度來考慮:
墊平整度
焊盤的平整度直接影響PCBA的焊接質量,特別是當板上有比較大的BGA或間距較小的μBGA時,當需要焊盤表面的保護層薄而均勻時,可以選擇ENIG、ENEPIG、OSP。
可焊性和潤濕性
可焊性始終是PCB的關鍵因素,在滿足其他要求的同時,建議選擇可焊性高的表面處理工藝,以確保回流焊的良率。
焊接頻率
PCB需要焊接或返工幾次? OSP這種表面處理製程不適合返工超過兩次。此時也會選擇沉金+OSP等複合表面處理製程。目前智慧型手機等高階電子產品都會選擇這種處理流程。
符合RoHS
PCBA中的引線元素主要來自元件引腳, PCB 焊盤和焊錫。 為了符合ROHS法規,PCB的表面處理方式也必須符合ROHS標準,例如ENIG、錫、銀、OSP等均符合ROHS標準。
金屬鍵合
如果需要金線或鋁線鍵合,則可能僅限於 ENIG、ENEPIG 和軟電解金。
焊點的可靠性
PCB的表面處理流程也會影響最終 PCBA焊接質量若要求焊點可靠性高,可選用沉金或鎳鈀金製程。


