01
กระบวนการบำบัดพื้นผิว PCB คืออะไร?
พื้นผิวทองแดงบน PCB โดยไม่มีการเคลือบหน้ากากประสาน เช่น แผ่นประสาน ตะกั่วบัดกรี นิ้วเชื่อมทอง รูกลไก ฯลฯ หากไม่มีการเคลือบป้องกัน พื้นผิวทองแดงจะถูกออกซิไดซ์ได้ง่าย ซึ่งจะส่งผลกระทบต่อการบัดกรีระหว่างทองแดงเปลือยและส่วนประกอบในพื้นที่บัดกรีได้ของ PCB
ดังแสดงในรูปด้านล่าง พื้นผิว การบำบัดจะอยู่ที่ชั้นนอกสุดของ PCB เหนือชั้นทองแดง โดยทำหน้าที่เป็น "การเคลือบ" บนพื้นผิวทองแดง
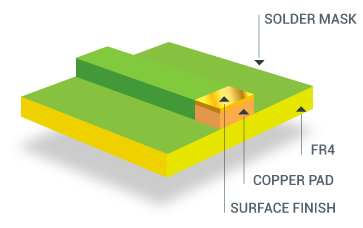
หน้าที่หลักของการบำบัดพื้นผิวคือการปกป้องพื้นผิวทองแดงที่สัมผัสกับวงจรออกซิเดชัน จึงทำให้มีพื้นผิวที่สามารถบัดกรีได้ในระหว่างการเชื่อม
02
การจำแนกประเภทของกระบวนการบำบัดพื้นผิว PCB
กระบวนการบำบัดพื้นผิว PCB แบ่งออกเป็นประเภทต่อไปนี้:
การปรับระดับการบัดกรีด้วยลมร้อน (HASL)
การแช่ดีบุก (ImSn)
เคมีภัณฑ์นิกเกิลทอง (ทองแช่) (ENIG)
สารกันบูดที่สามารถบัดกรีได้แบบออร์แกนิก (OSP)
เคมีเงิน (ImAg)
การชุบนิกเกิลด้วยสารเคมี การชุบแพลเลเดียมด้วยสารเคมี การแช่ในทองคำ (ENEPIG)
นิกเกิล/ทองอิเล็กโทรไลต์
การปรับระดับการบัดกรีด้วยลมร้อน (HASL)
ระดับการบัดกรีด้วยลมร้อน (HASL) หรือที่เรียกกันทั่วไปว่ากระป๋องสเปรย์ เป็นกระบวนการปรับสภาพพื้นผิวที่ใช้กันทั่วไปและมีราคาไม่แพงนัก แบ่งออกเป็น ไร้สารตะกั่ว กระป๋องสเปรย์ และ กระป๋องสเปรย์ตะกั่ว
อายุการใช้งานของ PCB สามารถเข้าถึงได้ถึง 12 เดือน โดยที่อุณหภูมิกระบวนการอยู่ที่ 250 ℃ และความหนาของการชุบผิวอยู่ที่ 1-40um
กระบวนการพ่นดีบุกเกี่ยวข้องกับการจุ่มแผงวงจรในของเหลวที่หลอมละลาย ประสาน (ดีบุก/ตะกั่ว) เพื่อปกคลุมพื้นผิวทองแดงที่โผล่ออกมาบน PCB เมื่อ PCB หลุดออกจากตะกั่วบัดกรีที่หลอมละลายแล้ว ลมร้อนแรงดันสูงจะพัดผ่านพื้นผิวด้วยมีดลม ทำให้ตะกั่วบัดกรีเกาะตัวกันเป็นก้อนและกำจัดตะกั่วบัดกรีส่วนเกินออกไป
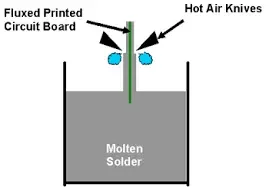
กระบวนการพ่นดีบุกต้องอาศัยความชำนาญในด้านอุณหภูมิในการเชื่อม อุณหภูมิของใบมีด แรงดันของใบมีด เวลาในการเชื่อมแบบจุ่ม ความเร็วในการยก ฯลฯ ตรวจสอบให้แน่ใจว่า PCB จุ่มอยู่ในตะกั่วบัดกรีที่หลอมละลายอย่างสมบูรณ์ และมีดลมสามารถเป่าตะกั่วบัดกรีให้ระเบิดได้ก่อนที่จะแข็งตัว แรงดันของมีดลมสามารถลดเมนิสคัสบน PCB ได้ พื้นผิวทองแดง และป้องกันการเชื่อมประสาน
การปรับระดับการบัดกรีด้วยลมร้อน (HASL)
ประโยชน์:
อายุการเก็บรักษานาน
เชื่อมได้ดี
ความต้านทานการกัดกร่อนและการเกิดออกซิเดชัน
การตรวจสอบด้วยสายตาสามารถทำได้
ข้อเสีย:
ความไม่เรียบของพื้นผิว
ไม่เหมาะกับอุปกรณ์ที่มีระยะห่างน้อย
ผลิตลูกปัดดีบุกได้ง่าย
การเสียรูปที่เกิดจากอุณหภูมิสูง
ไม่เหมาะกับการชุบด้วยไฟฟ้าผ่านรู
การแช่ดีบุก (ImSn)
Immersion Tin (ImSn) เป็นสารเคลือบโลหะที่เกิดจากปฏิกิริยาการแทนที่ทางเคมี โดยทาลงบนโลหะฐาน (เช่น ทองแดง) ของแผงวงจรโดยตรง ซึ่งสามารถตอบสนองความต้องการของชิ้นส่วนที่มีระยะพิทช์เล็กเพื่อความเรียบของพื้นผิว PCB ได้

การสะสมดีบุกสามารถปกป้องทองแดงที่อยู่ข้างใต้จากการเกิดออกซิเดชันได้ตลอดอายุการเก็บรักษา 3-6 เดือน เนื่องจากตะกั่วบัดกรีทั้งหมดมีส่วนประกอบเป็นดีบุก ชั้นการสะสมดีบุกจึงสามารถใช้ได้กับตะกั่วบัดกรีทุกประเภท หลังจากเติมสารเติมแต่งอินทรีย์ลงในสารละลายแช่ดีบุก โครงสร้างชั้นดีบุกจะกลายเป็นเม็ดเล็ก ๆ ช่วยแก้ปัญหาที่เกิดจากเศษดีบุกและการเคลื่อนตัวของดีบุกได้ ขณะเดียวกันก็ยังมี ความร้อนดี ความเสถียรและความสามารถในการเชื่อม
อุณหภูมิของกระบวนการสะสมดีบุกคือ 50 ℃ และความหนาของการชุบผิวคือ 0.8-1.2um PCB ที่เหมาะเป็นพิเศษสำหรับการเชื่อมต่อโดยการจีบ เช่น แผงหลังการสื่อสาร
การแช่ดีบุก (ImSn)
ประโยชน์:
เหมาะสำหรับระยะห่างน้อย/BGA
ความเรียบของพื้นผิวที่ดี
สอดคล้องกับ RoHS
เชื่อมได้ดี
เสถียรภาพที่ดี
ข้อเสีย:
เกิดการปนเปื้อนได้ง่าย
หนวดดีบุกอาจทำให้เกิดไฟฟ้าลัดวงจร
การทดสอบไฟฟ้าต้องใช้หัววัดแบบอ่อน
ไม่เหมาะสำหรับสวิตช์สัมผัส
กัดกร่อนชั้นหน้ากากประสาน
เคมีภัณฑ์นิกเกิลทอง (ทองแช่) (ENIG)
Chemical Nickel Immersion Gold (ENIG) สามารถตอบสนองความต้องการด้านความเรียบของพื้นผิวและการประมวลผลที่ปราศจากสารตะกั่วของ PCB สำหรับอุปกรณ์ที่มีระยะห่างระหว่างพิทช์เล็ก (BGA และ μ BGA)
ENIG ประกอบด้วยชั้นเคลือบโลหะสองชั้น โดยนิกเกิลจะเคลือบบนพื้นผิวทองแดงผ่านกระบวนการทางเคมี จากนั้นจึงเคลือบด้วยอะตอมทองคำผ่านปฏิกิริยาการแทนที่ ความหนาของนิกเกิลอยู่ที่ 3-6 μm และความหนาของทองคำอยู่ที่ 0.05-0.1 μm นิกเกิลทำหน้าที่เป็นเกราะป้องกันทองแดงและเป็นพื้นผิวที่ส่วนประกอบต่างๆ ถูกบัดกรี บทบาทของทองคำคือป้องกันการเกิดออกซิเดชันของนิกเกิลระหว่างการจัดเก็บ โดยมีอายุการเก็บรักษาประมาณหนึ่งปี และสามารถทำให้แน่ใจได้ว่านิกเกิลจะคงอยู่ได้ ความเรียบผิวที่ยอดเยี่ยม.
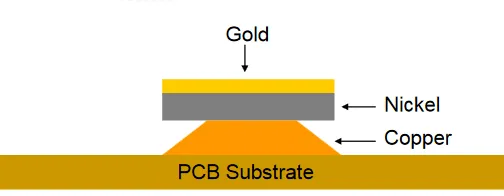
กระบวนการจุ่มทองใช้กันอย่างแพร่หลายในบอร์ดที่มีความหนาแน่นสูง บอร์ดแข็งแบบธรรมดา และบอร์ดอ่อน โดยมีความน่าเชื่อถือสูงและรองรับการยึดด้วยลวดโดยใช้ลวดอลูมิเนียม ใช้กันอย่างแพร่หลายในอุตสาหกรรมต่างๆ เช่น ผู้บริโภค การสื่อสาร/การคำนวณ การบินและอวกาศ และการดูแลสุขภาพ
เคมีคัลนิกเกิลโกลด์ (ENIG)
ประโยชน์:
อายุการเก็บรักษานาน
บอร์ดความหนาแน่นสูง (μ BGA)
การยึดลวดอลูมิเนียม
ความเรียบผิวสูง
เหมาะกับการชุบรูด้วยไฟฟ้า
ข้อเสีย:
ราคาแพง
การลดทอนสัญญาณ RF
ไม่สามารถแก้ไขได้
แผ่นสีดำ/นิกเกิลสีดำ
กระบวนการประมวลผลมีความซับซ้อน
สารกันบูดที่สามารถบัดกรีได้แบบออร์แกนิก (OSP)
สารกันเสียจากการบัดกรีอินทรีย์ (OSP) เป็นวัสดุป้องกันชั้นบางมากที่ทาลงบนทองแดงที่สัมผัสกับอากาศเพื่อปกป้องพื้นผิวทองแดงไม่ให้เกิดการออกซิเดชัน
ฟิล์มอินทรีย์มีคุณสมบัติ เช่น ทนทานต่อการเกิดออกซิเดชัน ทนทานต่อแรงกระแทกจากความร้อน และทนต่อความชื้น ซึ่งสามารถปกป้องพื้นผิวทองแดงจากการเกิดออกซิเดชันหรือซัลเฟอร์ไรเซชันภายใต้สภาวะปกติ ในกระบวนการเชื่อมหลังอุณหภูมิสูง ฟิล์มอินทรีย์จะถูกขจัดออกได้ง่ายด้วยฟลักซ์ ส่งผลให้พื้นผิวทองแดงที่สะอาดและเปิดโล่งเชื่อมติดกับทองแดงที่หลอมละลายทันที ประสานเพื่อสร้างการเชื่อมประสานที่แข็งแรงภายในระยะเวลาอันสั้น
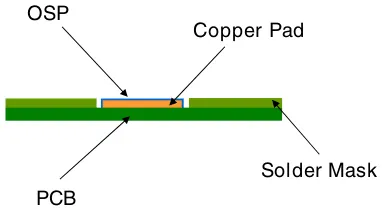
OSP เป็นสารประกอบอินทรีย์ที่มีส่วนประกอบเป็นน้ำซึ่งสามารถจับกับทองแดงได้อย่างเฉพาะเจาะจงเพื่อปกป้องพื้นผิวทองแดงก่อนการเชื่อม เมื่อเปรียบเทียบกับกระบวนการบำบัดพื้นผิวแบบไร้สารตะกั่วอื่นๆ OSP เป็นมิตรต่อสิ่งแวดล้อมมาก เนื่องจากกระบวนการบำบัดพื้นผิวอื่นๆ อาจมีพิษหรือใช้พลังงานสูงกว่า
สารกันบูดที่สามารถบัดกรีได้แบบออร์แกนิก (OSP)
ประโยชน์:
ง่ายและราคาถูก
ปกป้องสิ่งแวดล้อมปราศจากสารตะกั่ว
พื้นผิวเรียบ
การต่อลวด
ข้อเสีย:
ไม่เหมาะสำหรับ PTH
อายุการเก็บรักษาสั้น
ไม่สะดวกต่อการตรวจสอบด้วยสายตาและไฟฟ้า
อุปกรณ์ ICT อาจทำให้ PCB เสียหายได้
เคมีเงิน (ImAg)
การจุ่มเงิน (ImAg) คือกระบวนการชุบทองแดงโดยตรงกับชั้นของเงินบริสุทธิ์โดยการจุ่ม PCB ลงในอ่างไอออนเงินผ่านปฏิกิริยาการแทนที่ เงินมีคุณสมบัติทางเคมีที่เสถียร PCB ที่ผ่านกระบวนการจุ่มเงินสามารถรักษาคุณสมบัติทางไฟฟ้าและการบัดกรีที่ดีได้แม้จะสัมผัสกับสภาพแวดล้อมที่ร้อน ชื้น และมลพิษ และแม้ว่าพื้นผิวจะสูญเสียความเงางามก็ตาม
บางครั้ง เพื่อป้องกันไม่ให้เงินทำปฏิกิริยากับซัลไฟด์ในสิ่งแวดล้อม การสะสมเงินจะรวมกับการเคลือบ OSP สำหรับการใช้งานส่วนใหญ่ เงินสามารถทดแทนทองได้ หากคุณไม่ต้องการใส่สารแม่เหล็ก (นิกเกิล) ลงใน PCB คุณสามารถเลือกใช้การสะสมเงินได้
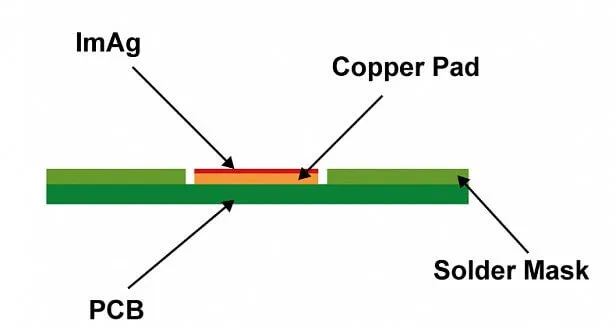
ความหนาของพื้นผิวของการสะสมเงินอยู่ที่ 0.12-0.40 μm และมีอายุการเก็บรักษาอยู่ที่ 6 ถึง 12 เดือน กระบวนการการสะสมเงินมีความอ่อนไหวต่อความสะอาดของพื้นผิวระหว่างการประมวลผล และจำเป็นต้องทำให้แน่ใจว่ากระบวนการผลิตทั้งหมดจะไม่ก่อให้เกิดการปนเปื้อนของพื้นผิวจากการสะสมเงิน กระบวนการการสะสมเงินเหมาะสำหรับการใช้งาน เช่น PCB สวิตช์ฟิล์มบาง และการยึดสายอลูมิเนียมที่ต้องมีการป้องกัน EMI
เงินจม (ImAg)
ประโยชน์:
ความเรียบผิวดี
ความสามารถในการเชื่อมสูง
เสถียรภาพที่ดี
ประสิทธิภาพการป้องกันที่ดี
เหมาะสำหรับการยึดลวดอลูมิเนียม
ข้อเสีย:
ไวต่อสารมลพิษ
ง่ายต่อการผ่านกระบวนการอิเล็กโตรไมเกรชั่น
หนวดโลหะสีเงิน
หน้าต่างประกอบสั้น ๆ หลังจากแกะกล่อง
ความยากในการทดสอบไฟฟ้า
การชุบนิกเกิลด้วยสารเคมี การชุบแพลเลเดียมด้วยสารเคมี การแช่ในทองคำ (ENEPIG)
เมื่อเปรียบเทียบกับ ENIG แล้ว ENEPIG จะมีชั้นแพลเลเดียมเพิ่มเติมระหว่างนิกเกิลและทองคำ ซึ่งจะช่วยปกป้องชั้นนิกเกิลจากการกัดกร่อนและป้องกันการเกิดแผ่นดำที่อาจเกิดขึ้นระหว่างการเคลือบผิว ENIG จึงทำให้ได้เปรียบในเรื่องความเรียบเนียนของพื้นผิว ความหนาของการเคลือบนิกเกิลอยู่ที่ประมาณ 3-6 μm ความหนาของแพลเลเดียมอยู่ที่ประมาณ 0.1-0.5 μm และความหนาของทองคำอยู่ที่ 0.02-0.1 μm แม้ว่าความหนาของนิกเกิลจะอยู่ที่ XNUMX μm ก็ตาม ชั้นทอง บางกว่า ENIG จึงมีราคาแพงกว่า
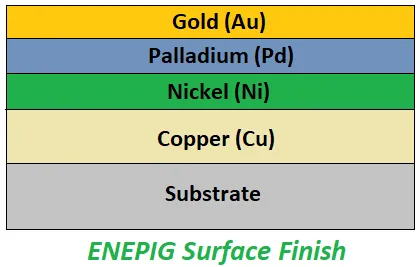
โครงสร้างชั้นของทองแดง นิกเกิล แพลเลเดียม ทองสามารถเชื่อมด้วยลวดเข้ากับชั้นชุบได้โดยตรง ชั้นสุดท้ายของทองจะบางและนิ่มมาก และความเสียหายทางกลไกที่มากเกินไปหรือรอยขีดข่วนลึกอาจทำให้ชั้นแพลเลเดียมถูกเปิดเผยออกมา
การชุบนิกเกิลด้วยสารเคมี การชุบแพลเลเดียมด้วยสารเคมี การแช่ในทองคำ (ENEPIG)
ประโยชน์:
พื้นผิวเรียบมาก
การต่อลวด
สามารถบัดกรีแบบรีโฟลว์ได้หลายครั้ง
ความน่าเชื่อถือสูงของข้อต่อบัดกรี
อายุการเก็บรักษานาน
ข้อเสีย:
ราคาแพง
การยึดลวดทองไม่น่าเชื่อถือเท่ากับการยึดทองคำแบบอ่อน
ผลิตลูกปัดดีบุกได้ง่าย
กระบวนการที่ซับซ้อน
ยากที่จะควบคุมกระบวนการการประมวลผล
นิกเกิล/ทองอิเล็กโทรไลต์
ทองนิกเกิลชุบด้วยไฟฟ้าแบ่งออกเป็น “ทองคำแข็ง” และ “ทองคำอ่อน”
ทองคำแข็งมีความบริสุทธิ์ต่ำ (99.6%) และมักใช้ทำนิ้วทอง (ขั้วต่อขอบ PCB)หน้าสัมผัส PCB หรือบริเวณที่สึกหรอยากอื่นๆ ความหนาของทองอาจแตกต่างกันไปตามความต้องการ
ทองคำอ่อนมีความบริสุทธิ์มากกว่า (99.9%) และนิยมนำมาใช้ในการยึดลวด
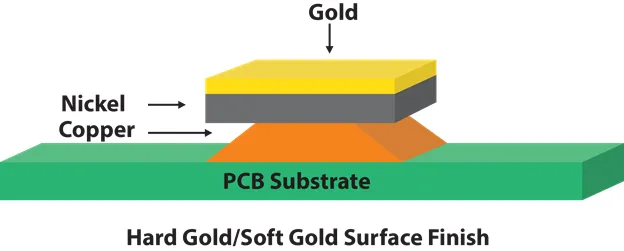
ทองคำอิเล็กโทรไลต์แข็ง
ทองคำแข็งคือโลหะผสมทองคำที่มีสารเชิงซ้อนของโคบอลต์ นิกเกิล หรือเหล็ก นิกเกิลที่มีความเครียดต่ำจะใช้ระหว่างการชุบทองและทองแดง ทองคำแข็งเหมาะสำหรับส่วนประกอบที่ใช้งานบ่อยและมีแนวโน้มสึกหรอสูง เช่น แผงวงจรหลัก แป้นกดทอง และแป้นพิมพ์
ความหนาของการเคลือบพื้นผิวด้วยทองคำแข็งอาจแตกต่างกันไปขึ้นอยู่กับการใช้งาน ความหนาสูงสุดที่สามารถเชื่อมได้สำหรับ IPC คือ 17.8 μin, 25 μin ในทองคำ และ 100 μin ในนิกเกิลสำหรับการใช้งาน IPC1 และ Class 2 และ 50 μin ในทองคำ และ 100 μin ในนิกเกิลสำหรับการใช้งาน IPC3
ทองคำอิเล็กโทรไลต์อ่อน
ส่วนใหญ่ใช้สำหรับ PCB ที่ต้องเชื่อมด้วยลวดและมีความสามารถในการบัดกรีสูง ข้อต่อบัดกรีทองอ่อนจะมีความปลอดภัยมากกว่าเมื่อเทียบกับทองแข็ง
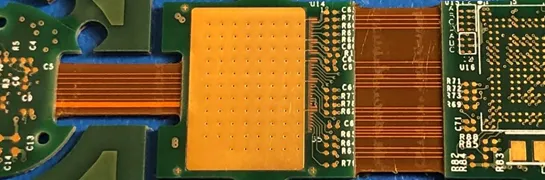
การเคลือบผิวด้วยทองคำอิเล็กโทรไลต์อ่อน
นิกเกิล/ทองอิเล็กโทรไลต์
ประโยชน์:
อายุการเก็บรักษานาน
ความน่าเชื่อถือสูงของข้อต่อบัดกรี
พื้นผิวที่ทนทาน
ข้อเสีย:
แพงมาก
นิ้วทองต้องมีการเดินสายนำไฟฟ้าเพิ่มเติมบนบอร์ด
ทองคำแข็งมีความสามารถในการเชื่อมต่ำ
03
เลือกกระบวนการบำบัดพื้นผิว PCB อย่างไร?
กระบวนการเคลือบพื้นผิวของ PCB จะส่งผลโดยตรงต่อผลลัพธ์ ปริมาณงานซ่อมอัตราความล้มเหลวในสถานที่ ความสามารถในการทดสอบ และอัตราของเสีย เพื่อคุณภาพและประสิทธิภาพของผลิตภัณฑ์ขั้นสุดท้าย จำเป็นต้องเลือกกระบวนการบำบัดพื้นผิวที่ตรงตามข้อกำหนดการออกแบบ ในทางวิศวกรรม สามารถพิจารณามุมมองต่อไปนี้:
ความเรียบของแผ่น
ความเรียบของแผ่นบัดกรีส่งผลโดยตรงต่อคุณภาพการบัดกรีของ PCBA โดยเฉพาะเมื่อมี BGA ขนาดค่อนข้างใหญ่หรือ BGA μ ที่มีระยะห่างระหว่างแผ่นบัดกรีน้อยกว่าบนบอร์ด สามารถเลือก ENIG, ENEPIG และ OSP ได้เมื่อจำเป็นต้องให้ชั้นป้องกันบนพื้นผิวแผ่นบัดกรีมีความบางและสม่ำเสมอ
ความสามารถในการบัดกรีและความสามารถในการเปียก
ความสามารถในการบัดกรีถือเป็นปัจจัยสำคัญสำหรับ PCB เสมอ แม้ว่าจะตรงตามข้อกำหนดอื่นๆ ก็ตาม ขอแนะนำให้เลือกกระบวนการชุบผิวที่มีความสามารถในการบัดกรีสูง เพื่อให้แน่ใจว่าจะได้ผลลัพธ์ของการบัดกรีแบบรีโฟลว์
ความถี่ในการเชื่อม
PCB จำเป็นต้องบัดกรีหรือซ่อมกี่ครั้ง? กระบวนการปรับปรุงพื้นผิวของ OSP ไม่เหมาะสำหรับการซ่อมแซมมากกว่าสองครั้ง ในเวลานี้ กระบวนการปรับปรุงพื้นผิวแบบผสม เช่น การแช่ทอง + OSP ก็จะถูกเลือกเช่นกัน ปัจจุบัน ผลิตภัณฑ์อิเล็กทรอนิกส์ระดับไฮเอนด์ เช่น สมาร์ทโฟน จะเลือกกระบวนการปรับปรุงนี้
เป็นไปตามมาตรฐานการปฏิบัติตาม
องค์ประกอบนำใน PCBA ส่วนใหญ่มาจากพินส่วนประกอบ แผ่น PCB และการบัดกรี เพื่อให้เป็นไปตามข้อบังคับ RoHS วิธีการเคลือบพื้นผิวของ PCB จะต้องเป็นไปตามมาตรฐาน ROHS ด้วย ตัวอย่างเช่น ENIG ดีบุก เงิน และ OSP ล้วนเป็นไปตามมาตรฐาน ROHS
พันธะโลหะ
หากจำเป็นต้องใช้การเชื่อมด้วยลวดทองหรืออลูมิเนียม อาจจำกัดให้ใช้เฉพาะ ENIG, ENEPIG และทองอิเล็กโทรไลต์อ่อนเท่านั้น
ความน่าเชื่อถือของข้อต่อบัดกรี
กระบวนการบำบัดพื้นผิวของ PCB อาจส่งผลต่อผลลัพธ์ขั้นสุดท้ายได้เช่นกัน คุณภาพการบัดกรีของ PCBAหากต้องการข้อต่อบัดกรีที่มีความน่าเชื่อถือสูง สามารถเลือกใช้กระบวนการจุ่มทองหรือทองคำนิกเกิลแพลเลเดียมได้




