01
PCB 표면처리 공정이란 무엇인가요?
구리 표면 PCB 솔더 패드, 골드 핑거, 기계적 구멍 등과 같은 솔더 마스크 커버리지가 없는 경우 보호 코팅이 없으면 구리 표면이 쉽게 산화되어 PCB의 납땜 가능 영역에 있는 맨 구리와 부품 간의 납땜에 영향을 미칩니다.
아래 그림과 같이, 표면 처리 과정은 구리 층 위의 PCB의 가장 바깥쪽 층에 위치하여 구리 표면의 "코팅" 역할을 합니다.
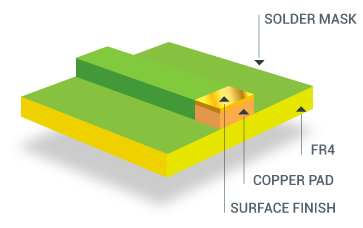
표면 처리의 주요 기능은 노출된 구리 표면을 산화 회로로부터 보호하여 용접 중 납땜이 가능한 표면을 제공하는 것입니다.
02
PCB 표면 처리 공정의 분류
PCB 표면 처리 공정은 다음과 같은 범주로 구분됩니다.
열풍 솔더 레벨링(HASL)
주석 침지(ImSn)
화학 니켈 금(침지 금)(ENIG)
유기 납땜 가능 방부제(OSP)
화학은(ImAg)
화학니켈도금, 화학팔라듐도금, 금침지(ENEPIG)
전해 니켈/금
열풍 솔더 레벨링(HASL)
HASL(Hot Air Solder Level)은 일반적으로 스프레이 주석(Spray Tin)으로 알려져 있으며, 가장 일반적으로 사용되고 비교적 저렴한 표면 처리 공정입니다. 무연 스프레이 틴과 납 스프레이 틴.
PCB의 저장 수명은 12개월에 달할 수 있으며, 공정 온도는 250℃, 표면 처리 두께 범위는 1~40um입니다.
주석 분무 공정에는 회로 기판을 용융된 용액에 담그는 작업이 포함됩니다. 납땜하다 PCB의 노출된 구리 표면을 덮기 위해 (주석/납)을 도포합니다. PCB가 녹은 땜납에서 분리되면, 고압의 뜨거운 공기가 에어 나이프로 표면을 통과하여 땜납을 평평하게 증착시키고 과도한 땜납을 제거합니다.
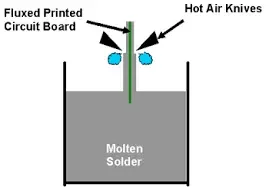
주석 용사 공정은 용접 온도, 블레이드 온도, 블레이드 압력, 침지 용접 시간, 리프팅 속도 등을 숙지해야 합니다. PCB가 용융된 솔더에 완전히 잠기도록 하고, 에어 나이프가 솔더가 응고되기 전에 불어낼 수 있도록 해야 합니다. 에어 나이프의 압력은 솔더의 메니스커스를 최소화할 수 있습니다. 구리 표면 솔더 브리징을 방지합니다.
열풍 솔더 레벨링(HASL)
이점:
긴 수명
좋은 용접성
부식 및 산화 저항
시각적 검사가 가능합니다
단점 :
표면 불균일성
간격이 작은 장치에는 적합하지 않습니다.
주석 구슬을 쉽게 생산할 수 있습니다
고온으로 인한 변형
구멍을 통한 전기 도금에는 적합하지 않습니다.
주석 침지(ImSn)
침지 주석(ImSn)은 화학적 치환 반응을 통해 증착된 금속 코팅으로, 회로 기판의 기본 금속(즉, 구리)에 직접 적용되며, PCB 표면 평탄성에 대한 소형 피치 부품의 요구 사항을 충족할 수 있습니다.

주석 증착은 3~6개월의 유효 기간 동안 하부 구리를 산화로부터 보호할 수 있습니다. 모든 솔더는 주석 기반이므로 주석 증착층은 모든 유형의 솔더와 일치할 수 있습니다. 주석 침지 용액에 유기 첨가제를 첨가하면 주석층 구조가 입상화되어 주석 위스커 및 주석 마이그레이션으로 인한 문제를 해결하는 동시에 좋은 열 안정성과 용접성.
주석 증착 공정 온도는 50℃이며, 표면 처리 두께는 0.8~1.2um입니다. 통신 백보드와 같이 압착을 통한 연결에 특히 적합한 PCB입니다.
주석 침지(ImSn)
이점:
좁은 간격/BGA에 적합
좋은 표면 평활도
RoHS 준수
좋은 용접성
좋은 안정성
단점 :
오염되기 쉽다
주석 수염은 단락을 일으킬 수 있습니다.
전기 테스트에는 소프트 프로브가 필요합니다.
접점 스위치에 적합하지 않습니다.
솔더 마스크 층에 부식성 있음
화학 니켈 금(침지 금)(ENIG)
ENIG(Chemical Nickel Immersion Gold)는 소형 피치 장치(BGA 및 μ BGA)용 PCB의 표면 평탄도 및 무연 처리 요구 사항을 충족할 수 있습니다.
ENIG는 두 겹의 금속 코팅으로 구성되어 있으며, 화학적 공정을 통해 구리 표면에 니켈을 증착한 후 치환 반응을 통해 금 원자로 코팅합니다. 니켈의 두께는 3~6μm이고 금의 두께는 0.05~0.1μm입니다. 니켈은 구리에 대한 장벽 역할을 하며, 부품이 실제로 납땜되는 표면입니다. 금의 역할은 보관 중 니켈 산화를 방지하는 것이며, 약 XNUMX년의 저장 수명을 보장합니다. 우수한 표면 평탄도.
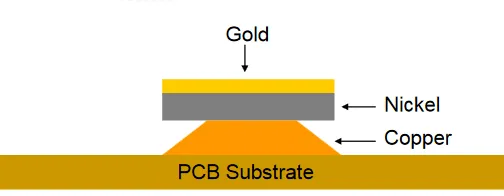
침지 금도금 공정은 고밀도 기판, 일반 경질 기판, 연질 기판에 널리 사용되며, 높은 신뢰성과 알루미늄 와이어를 사용한 와이어 본딩을 지원합니다. 소비재, 통신/컴퓨팅, 항공우주, 의료 등 다양한 산업 분야에서 널리 사용됩니다.
화학 니켈 금(ENIG)
이점:
긴 수명
고밀도 보드(μ BGA)
알루미늄 와이어 본딩
높은 표면 평탄도
전기 도금 구멍에 적합
단점 :
비싼 가격
RF 신호의 감쇠
재작업이 불가능합니다
블랙 패드/블랙 니켈
처리과정이 복잡하다
유기 납땜 가능 방부제(OSP)
유기 납땜 방부제(OSP)는 구리 표면을 산화로부터 보호하기 위해 노출된 구리에 적용되는 매우 얇은 소재의 보호층입니다.
유기 피막은 내산화성, 내열충격성, 내습성 등의 특성을 가지고 있어 정상적인 조건에서 구리 표면을 산화 또는 황화로부터 보호할 수 있습니다. 고온 용접 후 공정에서 유기 피막은 플럭스에 의해 쉽게 제거되어 노출된 깨끗한 구리 표면이 용융된 구리 표면과 즉시 접합됩니다. 납땜하다매우 짧은 시간 안에 강한 솔더 조인트를 형성합니다.
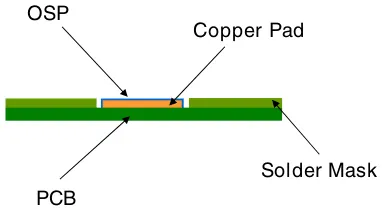
OSP는 수성 유기 화합물로, 용접 전 구리 표면을 보호하기 위해 구리와 선택적으로 결합할 수 있습니다. 다른 무연 표면 처리 공정과 비교했을 때, 다른 표면 처리 공정은 독성이 있거나 에너지 소비량이 높을 수 있지만 OSP는 매우 친환경적입니다.
유기 납땜 가능 방부제(OSP)
이점:
간단하고 저렴하다
무연 환경 보호
매끄러운 표면
와이어 본딩
단점 :
PTH에 적합하지 않음
짧은 유통 기한
시각적 및 전기적 검사에 편리하지 않음
ICT 고정물이 PCB를 손상시킬 수 있습니다.
화학은(ImAg)
침지 은도금(ImAg)은 PCB를 은 이온 용액에 침지하여 치환 반응을 통해 구리에 순은 층을 직접 도금하는 공정입니다. 은은 안정적인 화학적 특성을 가지고 있습니다. 은 침지 기술을 통해 가공된 PCB는 고온, 다습, 오염된 환경에 노출되거나 표면 광택이 사라지더라도 우수한 전기적 특성과 납땜성을 유지할 수 있습니다.
때로는 은이 주변 환경의 황화물과 반응하는 것을 방지하기 위해 OSP 코팅과 은 증착을 병행합니다. 대부분의 경우 은은 금을 대체할 수 있습니다. PCB에 자성 물질(니켈)을 첨가하고 싶지 않다면 은 증착을 사용할 수 있습니다.
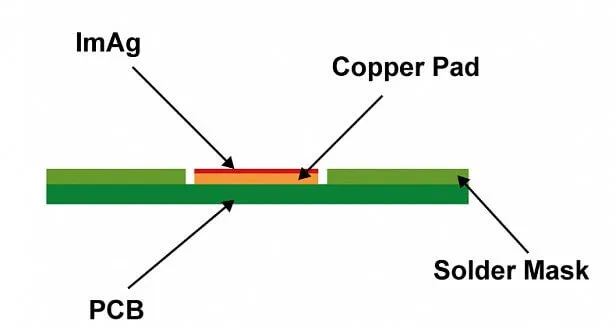
은 증착의 표면 두께는 0.12~0.40μm이며, 유효 기간은 6~12개월입니다. 은 증착 공정은 공정 중 표면 청결에 민감하므로, 전체 생산 공정에서 은 증착으로 인한 표면 오염이 발생하지 않도록 해야 합니다. 은 증착 공정은 EMI 차폐가 필요한 PCB, 박막 스위치, 알루미늄 와이어 본딩 등의 용도에 적합합니다.
침몰은(ImAg)
이점:
좋은 표면 평탄도
높은 용접성
좋은 안정성
우수한 차폐 성능
알루미늄 와이어 본딩에 적합
단점 :
오염 물질에 민감하다
전기이동이 용이하다
은색 금속 수염
포장 풀고 나서 짧은 조립 시간
전기 테스트의 어려움
화학니켈도금, 화학팔라듐도금, 금침지(ENEPIG)
ENIG와 비교했을 때, ENEPIG는 니켈과 금 사이에 팔라듐 층을 추가하여 니켈 층을 부식으로부터 더욱 보호하고 ENIG 표면 처리 중 발생할 수 있는 블랙 패드 발생을 방지하여 표면 평활도 향상에 유리합니다. 니켈 증착 두께는 약 3~6μm, 팔라듐 증착 두께는 약 0.1~0.5μm, 금 증착 두께는 0.02~0.1μm입니다. 금층 ENIG보다 얇지만 가격이 더 비쌉니다.
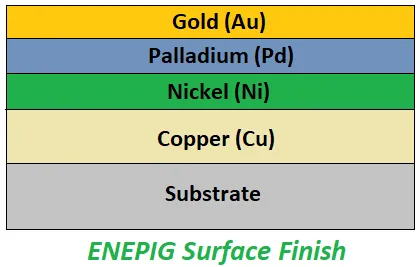
구리 니켈 팔라듐 금의 층 구조는 도금층에 직접 와이어 본딩이 가능합니다. 마지막 금 층은 매우 얇고 부드러워 과도한 기계적 손상이나 깊은 긁힘으로 인해 팔라듐 층이 노출될 수 있습니다.
화학니켈도금, 화학팔라듐도금, 금침지(ENEPIG)
이점:
매우 평평한 표면
와이어 본딩
여러 번 리플로우 납땜이 가능합니다.
솔더 접합부의 높은 신뢰성
긴 수명
단점 :
비싼 가격
골드 와이어 본딩은 소프트 골드 본딩만큼 신뢰할 수 없습니다.
주석 구슬을 쉽게 생산할 수 있습니다
복잡한 프로세스
가공 과정을 제어하기 어려움
전해 니켈/금
전기도금 니켈 골드는 '하드 골드'와 '소프트 골드'로 구분됩니다.
경금은 순도가 낮고(99.6%) 일반적으로 금지용으로 사용됩니다. (PCB 엣지 커넥터), PCB 접점 또는 기타 마모가 심한 부위에 적용됩니다. 금의 두께는 요구 사항에 따라 달라질 수 있습니다.
연성금은 순도가 더 높고(99.9%) 와이어 본딩에 일반적으로 사용됩니다.
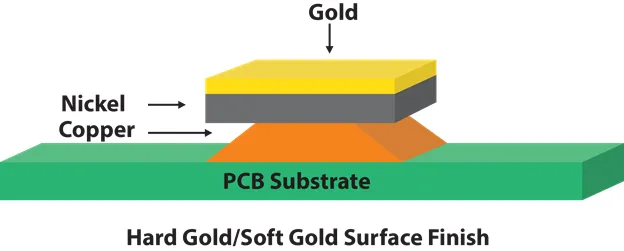
경질 전해 금
경금은 코발트, 니켈 또는 철 복합물을 포함하는 금 합금입니다. 금도금과 구리 사이에는 저응력 니켈이 사용됩니다. 경금은 캐리어 보드, 골드 핑거, 키패드처럼 자주 사용되고 마모될 가능성이 높은 부품에 적합합니다.
경질 금 표면 처리 두께는 용도에 따라 달라질 수 있습니다. IPC의 권장 최대 용접 가능 두께는 17.8μin이며, IPC25 및 100등급의 경우 금 1μin, 니켈 2μin입니다. IPC50 등급의 경우 금 100μin, 니켈 3μin입니다.
연성 전해 금
주로 와이어 본딩과 높은 납땜성이 요구되는 PCB에 사용되는 소프트 골드 납땜 접합부는 하드 골드에 비해 더욱 안전합니다.
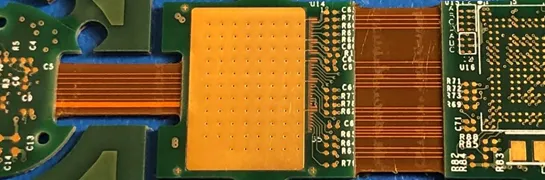
연성 전해 금 표면 처리
전해 니켈/금
이점:
긴 수명
솔더 접합부의 높은 신뢰성
튼튼한 표면
단점 :
매우 비싼
골드 핑거에는 보드에 추가 전도성 배선이 필요합니다.
경금은 용접성이 좋지 않습니다.
03
PCB 표면 처리 공정을 어떻게 선택합니까?
PCB의 표면 처리 공정은 출력에 직접적인 영향을 미칩니다. 재작업 수량, 현장 고장률, 시험 능력, 그리고 불량률. 최종 제품의 품질과 성능을 위해서는 설계 요건을 충족하는 표면 처리 공정을 선택해야 합니다. 엔지니어링 분야에서는 다음과 같은 관점을 고려할 수 있습니다.
패드 평탄도
솔더 패드의 평탄도는 PCBA의 납땜 품질에 직접적인 영향을 미치며, 특히 보드에 비교적 큰 BGA 또는 작은 피치 μ BGA가 있는 경우 솔더 패드 표면의 보호층이 얇고 균일해야 하는 경우 ENIG, ENEPIG 및 OSP를 선택할 수 있습니다.
납땜성 및 젖음성
PCB의 납땜성은 항상 중요한 요소입니다. 다른 요건들을 충족하는 동시에, 리플로우 솔더링의 수율을 보장하기 위해 납땜성이 높은 표면 처리 공정을 선택하는 것이 좋습니다.
용접 빈도
PCB는 몇 번 납땜 또는 재작업해야 합니까? OSP 표면 처리 공정은 두 번 이상 재작업하는 데 적합하지 않습니다. 현재 침지 금도금+OSP와 같은 복합 표면 처리 공정도 선택될 것입니다. 현재 스마트폰과 같은 고급 전자 제품에는 이러한 처리 공정이 사용됩니다.
RoHS 규제 준수
PCBA의 리드 요소는 주로 구성 요소 핀에서 나옵니다. PCB 패드와 납땜. ROHS 규정을 준수하려면 PCB 표면 처리 방식 또한 ROHS 기준을 준수해야 합니다. 예를 들어 ENIG, 주석, 은, OSP는 모두 ROHS 기준을 준수합니다.
메탈 본딩
금이나 알루미늄 와이어 본딩이 필요한 경우 ENIG, ENEPIG 및 연성 전해 금으로 제한될 수 있습니다.
솔더 조인트의 신뢰성
PCB의 표면 처리 공정은 최종 결과에도 영향을 미칠 수 있습니다. PCBA의 납땜 품질높은 신뢰성의 솔더 접합부가 필요한 경우 침지 금 또는 니켈 팔라듐 금 공정을 선택할 수 있습니다.




